近期,沙特国王科技大学李晓航教授研究团队首次实现了超宽禁带β-Ga₂O₃鳍式场效应晶体管(FinFETs)及逻辑反相器集成电路在2K极低温下的稳定工作,这是超宽禁带半导体在低温电子学领域的重大突破。研究成果以“TwoKelvinOperationofUltrawide-Bandgapβ-Ga₂O₃FinFETsandLogicInverterIntegratedCircuits”发表于《nanoletters》上。

背景
抗极端温度电子器件对于从量子计算到太空探索等应用至关重要。超宽禁带(UWBG)β-Ga₂O₃半导体有望在低温至高温范围内工作;然而,其低温性能尚未得到充分探索。本研究通过利用莫特变程跳跃(VRH)在杂质带中的传导,展示了β-Ga₂O₃晶体管在2K下的工作。β-Ga₂O₃FinFETs表现出增强型模式行为,在2K时阈值电压为1.87V,开关电流比超过10⁶,亚阈值摆幅为152mV/dec。此外,实现了单片集成的β-Ga₂O₃反相器集成电路,在5V电源下2K时实现4.88V的电压摆幅和28的电压增益,直流功耗为0.13μW。稳定的低温性能源于FinFET架构和精确掺杂,这些设计使得VRH成为可能,与β-Ga₂O₃沟道的双带输运模型一致,从而确立了β-Ga₂O₃低温电子学。
能够在极端温度下工作的电子器件在广泛的应用领域中备受青睐,包括低温电子学、汽车发动机控制、井下钻探和太空探索。例如,量子计算机需要工作在4K低温下的低温电子学。太空系统中的电子器件暴露于大幅度的温度变化,水星表面温度范围为90-700K,月球表面为100-400K。通常,在这些环境中工作的电子电路需要热控制或屏蔽,这导致系统尺寸和重量大、成本高。一个可行的解决方案是实现能够抵抗极端温度(低温和高温)的电子器件。使用宽禁带(WBG)和超宽禁带(UWBG)半导体开发极端温度电子器件可能比硅更有优势,因为它们已经表现出高达500°C高温下的稳定器件性能。然而,WBG半导体的低温工作由于载流子冻结效应而显示出退化的器件性能。例如,WBG碳化硅(SiC)和体相氮化镓(GaN)在接近100K时表现出载流子冻结,导致导通电阻大幅增加和晶体管特性中阈值电压升高。GaN基异质结构中的极化诱导二维载流子气没有载流子冻结,但仅限于横向器件结构,并在100K附近表现出扭折效应。
尽管如此,UWBGβ-氧化镓(β-Ga₂O₃)半导体由于其在Sn掺杂β-Ga₂O₃原生衬底中展示出直至2K的无电子冻结特性,对低温应用具有前景。另一项关于β-Ga₂O₃外延薄膜的研究显示直至40K无电子冻结。这一观察表明β-Ga₂O₃器件用于低温工作的潜力,具有以下显著优势:(1)由于其体相低温特性,横向和纵向β-Ga₂O₃器件如二极管和晶体管都可以在2K下实现;(2)低成本熔融生长原生衬底上的高质量可扩展β-Ga₂O₃外延薄膜表明其适用于各种器件,包括晶体管、二极管、逻辑电路和驱动器,可进一步促进具有大量片上功能的单片集成高紧凑低温芯片的开发;(3)Ga₂O₃具有约4.8eV的UWBG和约8MV/cm的大临界电场,对低温功率电子学具有重要意义;(4)在低温工作条件下,β-Ga₂O₃可以成为星际太空探测器的绝佳选择,其卓越的高温器件操作和抗辐射性是关键因素。
主要内容
本研究首次实现了超宽禁带β-Ga₂O₃鳍式场效应晶体管(FinFETs)及逻辑反相器集成电路在2K极低温下的稳定工作,这是超宽禁带半导体在低温电子学领域的重大突破。研究团队采用FinFET架构结合精确控制的硅掺杂技术,在半绝缘(010)β-Ga₂O₃衬底上通过脉冲激光沉积生长600nm厚同质外延硅掺杂β-Ga₂O₃薄膜,开发了用于沟道的n⁻-Ga₂O₃(2.3×10¹⁸cm⁻³)和用于欧姆接触的n⁺-Ga₂O₃(4.9×10¹⁹cm⁻³)两种掺杂分布。器件制备采用电子束光刻和电感耦合等离子体刻蚀形成高宽比约6的三角形鳍结构(鳍宽104nm,鳍深596nm),原子层沉积Al₂O₃栅介质,电子束蒸发Pt/Au栅电极和Ti/Au源漏电极,每个FinFET包含55个并联鳍片。
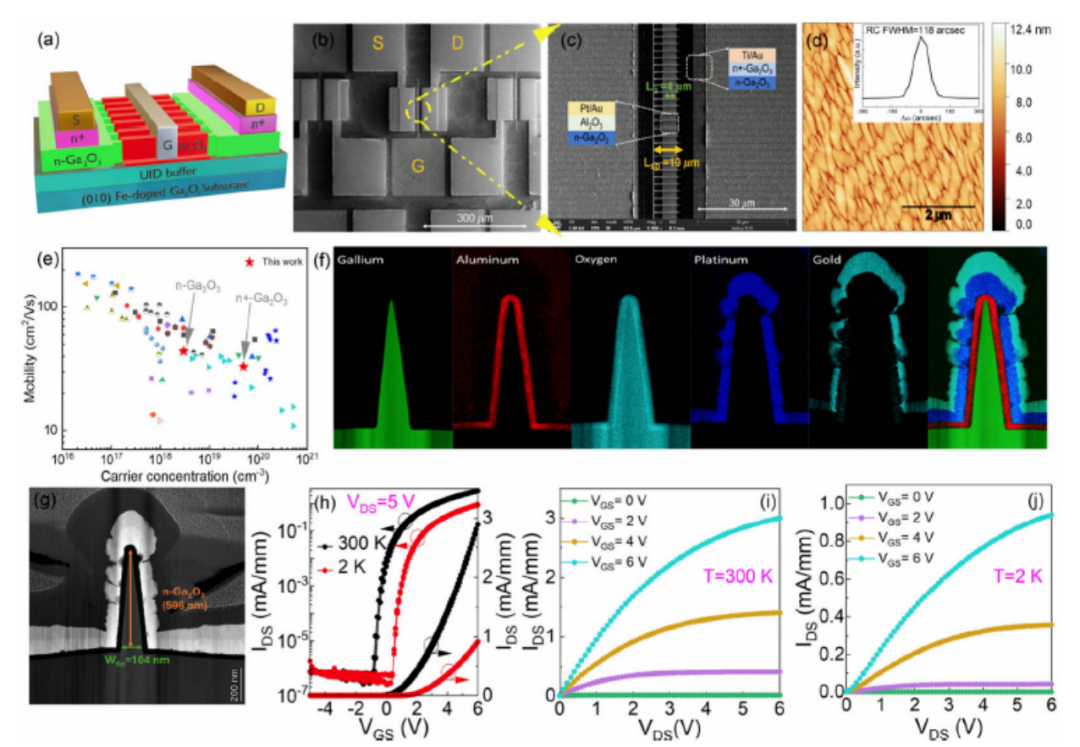
图1β-Ga2O3FinFET器件:(a)三维结构示意图;(b)顶部SEM视图标注源极(S)、漏极(D)和栅极(G);(c)鳍式沟道区域放大图显示接触间距LCH=LSD=10μm,栅长LG=4μm。掺硅β-Ga2O3薄膜:(d)原子力显微镜(AFM)表面形貌显示RMS粗糙度1.1nm,插图为(020)晶面XRD摇摆曲线,半高宽105弧秒;(e)PLD法制备n-/n+型β-Ga2O3薄膜性能与文献对比;(f)关键元素的电子能量损失谱(EELS)成像;(g)鳍式结构横截面TEM图像及尺寸标注;(h)300K和2K下VDS=5V时的转移特性曲线;(i)(j)分别为300K和2K下不同栅压VGS的输出特性曲线。

图2β-Ga2O3FinFET在300K至2K温区的电学特性表征:(a)VDS=5V时的转移特性曲线;(b)VGS=6V时的输出特性曲线;(c)迟滞电压ΔVHY与阈值电压VTH的变化规律;(d)亚阈值摆幅SS的温度依赖性;(e)导通电阻RON和场效应迁移率μFE的参数演变;(f)栅宽分别为175nm、150nm和104nm的β-Ga2O3FinFET在300K和2K下的耗尽型(D-mode)与增强型(E-mode)工作特性。

图3β-Ga2O3薄膜在不同温度下的电学特性:(a)载流子浓度n和迁移率μ,其中n在140K出现最小值;(b)电阻率ρ和(c)霍尔系数RH,红菱形标记为双带模型计算结果与实验数据精确吻合;(d)Rxx(H)曲线显示T≤180K时出现核磁共振(NMR)信号,表明杂质带(IB)存在,且Gxy(H)的双带模型拟合良好(黄色实线);(e)β-Ga2O3薄膜及FinFET器件中划分的三个温度区间导电机制总结;(f)亚阈值摆幅(SS)异常行为的解释,归因于T